窒化物エピ基板
次世代パワー半導体や高周波デバイスに用いられるワイドバンドギャップ材料である窒化ガリウム(GaN)。当社の窒化ガリウムエピ基板は独自のバッファー層により高耐圧と良好な平坦性の両立をSi基板上に実現しました。(GaN on Si HEMTエピ基板)

研究開発用を中心としたエピタキシャル成長委託に対応いたします。
p-GaNキャップ層やAlGaN DH構造などの層構造、炭化ケイ素(SiC)をはじめとするその他の基板上でのエピタキシャル成長についても、ご要望に応じて対応を検討いたします。
| 用途 | ||||
| パワー半導体用途:インバータ、AC-DCコンバータ | ||||
| 高周波デバイス用途:携帯電話基地局向け | ||||
|
| 製品特徴(GaN on Si HEMTエピ基板) |
| 高耐圧(1000V)&低リーク電流(1E-6A) |
| クラックフリー |
| 良好な反り(Bow<50μm) |
| ウェハサイズ(3、4、6インチ) |
| 厚膜対応可能(4.8μm |
| p-GaN cap層、AlGaN DH構造(4.8μm |
| 製品特性(GaN on Si HEMTエピ基板) | ||||||||||||||||||||||||
| Standard HEMT Structure | ||||||||||||||||||||||||
|
| Substrate | ||||||||||||||
|
| Electrical properties | ||||||||
|
| Vertical/Horizontal leak current |
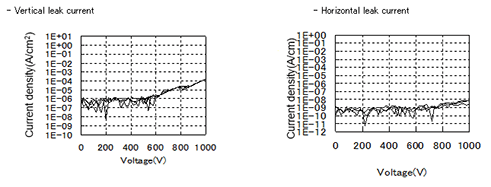 |
| 注記 |
| ・推奨用途:パワースイッチングデバイス |
| ・記載値、特性はtypical値です。 |
| ・ご要望に応じて構造、特性を調整いたします。 |
| ・p-GaN cap層、AlGaNバッファー構造も対応可能です。 |
| 製品特性(AINテンプレート) | ||||||||||||||||||||
|
||||||||||||||||||||
 |


